新功率设备的老化特性:HTOL高温老化测试
发布时间:2025-05-28 14:14
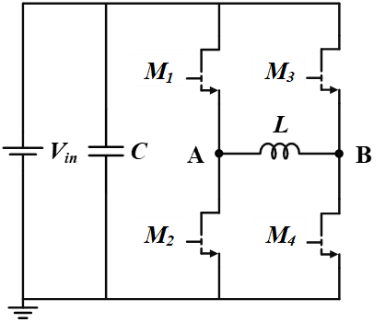 由于技术的持续发展,由于其出色的性能,新的能源设备(例如硅(SIC)碳化物(SIC)碳化物(SIC)碳化物(GAN)(GAN))已被广泛用于各种电子设备。但是,这些设备在连续长期使用后会衰老并导致性能较低。如何在短时间内精确地评估这些设备的老化特性已成为行业护理的重点。本文引用:目前,能源设备衰老测试主要意味着多种测试方法。其中,由JEDEC(HTGB,HTRB,H3TRB,功率周期测试等)制定的老化测试标准主要针对传统的硅功率设备。对于诸如SIC之类的较新功率设备,AQG-324标准需要临时动态老化UE,例如动态门偏置和动态逆极化测试。这些传统测试方法中的大多数都使用独特的应力条件来加速能量设备的衰老并了解Agin设备测试特定指标的g。但是,由于压力条件的特异性,这些方法使得在老化测试期间很难评估设备性能。传统的独特张力测试方法无法检测到潜在的缺陷问题,尤其是当它们面对新的能量设备时,这可能会阻碍您真正使用的设备的长期可靠性的确切预测。新的老化测试方法:高温工作状态老化测试,以评估能量设备衰老的较彻底的衰老,高温工作条件的衰老测试逐渐吸引了能量设备测试工程师的注意。 HTOL通过将电源设备放置在实际电源电路中,模拟操作条件下的操作条件。在使用连续硬开关或软开关电路的衰老测试中施加压力时,HTOL可以提供接近实际情况的老化效果,这可以更精确地反射N设备在全面的压力条件下的性能。以硬开关的老化为例,指的是JEP182标准中给出的一些HTOL测试拓扑结构,所测试的设备分别是电路中的硬开关,软开关和InterCoursersistive载荷上升。它可以在拓扑回路的几个结构中找到。这种证明方法可以更全面地模拟设备在现实世界应用中的工作状态,从而使您可以更有效地评估长期可靠性。例如,电路结构类似于双重脉冲形状,在冰点阶段,将功率电阻添加到上管电路中,以消耗电感能量,从而确保在连续开关过程中的当前平衡。由于L电感器的能量在电阻R中消散,因此电阻R会产生大量热量,并且应在高功率中使用大型散热器测试条件,导致更大的电路容量,显着限制了电路运行的总功率,以及在高体积和高电流条件下无法操作的。为了提高衰老效率,通过在衰老过程中改善压力条件并允许能源供应设备解决实际情况,可以改善测试电路。消除了老化电路的电阻载荷,以减少散热量并提高电路的运行效率。电感载荷的使用使食品装置可以在艰苦的切换条件下工作,从而避免能量转化为热量消散。可以按顺序控制四个电源设备中的开关的顺序,Q1/Q4在连续的硬开关条件下运行,而Q2/Q3在自由的当前条件下工作,该条件可以达到连续的硬开关电路,而无需电阻载荷。 QQ Micro 650V GAN HEMT设备用作HTO测试的示例,经常控制LED切换为100 kHz。在连续开关过程中,请使用示波器(TEK),高压电源(高压CC电源EA 1500V)和夹具测试探针(小于100 ns稳定时间)来测量通道中电源设备阻力变化的趋势,并了解通行设备内衬的过程。例如,使用GAN QQ 650V设备在HTOL测试中进行了实际测试用例和结果分析。在测试过程中,使用Tektronix示波器,高压CC电源EE EA 1500V和电动Hunan Lanhai的夹具探测器测量了开关过程中功率设备的电阻趋势。设备开关序列的食物源控制提供了无电压载荷的硬开关电路连续。测试的结果表明,在测试的61 h期间,GAN的电阻动力学和Mosfet de Cree SiC设备基本上保持稳定,而没有显着增加。后520V测试电压的额外增加,在测试245小时后,电阻的动态电阻缓慢增加,但总体情况仍然在合理的范围内。线性调整使您可以在某些条件下预测设备的连续操作寿命。下图使用Tektronix MSO58B系列的示波器显示了动态电阻波形。将电压和电阻电流分开以在特定位置获得动态电阻值。经过长时间的测试,您可以看到动态电阻的相对漂移。在测试期间,Font Decites De Food的连续硬开关会产生开关损失,从而导致自己的热量产生。为避免由影响能量设备特性变化的加热引起的联合温度变化,请通过外部红外温度测试监测设备的温度,并通过热V建立闭路电路以进行温度控制诱使耗散以确保在长期操作期间能量装置连接温度的稳定性。在第一次测试中,选择了QRX Micro TO-247-4包装的功率设备,以将CREE的MOSFET SIC C3M0040120D(1200V/66A)进行比较和测试。测试条件是一致的,与80°C设备的温度,100 kHz开关频率,15A工作电流和400V操作电压。在PRU61 -小时EBA中,我们比较了两种不同类型的设备的动态电阻变化曲线,如下图所示(垂直轴是米利奥姆斯的电阻电阻):蓝色曲线是Cree设备的动态电阻测试的结果,大约1100万。红色曲线表明,GAN设备的动态电阻测试的结果约为54毫米。曲线正面的脉冲峰是由测试过程中调节测试参数引起的。在s期间AME时期,这两个设备的动态电阻基本上保持稳定,并且在测试过程中会发生显着增加。 。在老化过程中,CC电源的输出电压为400 V,CC电流小于100 mA。在测试过程中,单个设备消耗的CC功率少于40 W。与传统的HTOL衰老电流相比,节省了大量能源消耗并降低了测试成本。为了进一步提高衰老率并看到最明显的衰老效应,在第二个测试中,选择了工作电压作为衰老加速度因子,将测试电压从400V增加到520V。由于未更改其他测试条件,因此再次进行了测试。 HTOL的总执行时间增加到245小时,总计29,100个电阻测试结果,每个测试结果为30秒的时间间隔。上图显示,对于大约10天的连续测试,垂直轴数据是动态的结果图中显示了IC电阻测试,水平轴是测试的样品点的序列号,并且正在测试的处置功率IVA的动态电阻变化曲线显示在图中。尽管由于测试环境中的日间变化和夜间温度的影响,测试结果发生了周期性变化,但长期趋势表明,动态电阻正在缓慢增加。与下图同一时期北京的天气数据相比,我们可以看到起伏基本上是相同的,并且环境温度对测试结果具有特定的影响。通过线性调整数据结果,我们可以获得增加动态电阻的斜率约为6.93*E-5。假设能量设备的动态公差增加了30%,则可以达到限制。第二,在80°设备的520V,15a,CA温度的证明下,一个50%的工作周期,设备的连续工作寿命可以达到1724小时。考虑到设备的实际操作电压为400 V,在正常工作条件下的连续时间比此值更长。通过真实的测试数据,我们可以看到,Quanxinwei提供的650V高压GAN设备基本上与SIC设备相同的质量水平就老化的特征而言。当工作电压增加到520V时,可以看出耐受性会缓慢增加,但可以保持较长的工作寿命。一种快速简便的方法,可以通过类似于HTOLCOMPREBER的HTOL老化测试方法来减少衰老过程和新能量设备的性能,并帮助研发工程师和设计快速改善设计并改善生产力的性能。 Tektronix Innovation Lab:帮助您尝试评估能源设备。 Tektronix Innovation Lab v2.0显着提高了可以满足DIV的测试功能ERSE设备测试需要第三代半导体的全面更新和更新和电源设备。该更新涵盖了GAN设备更改测试,动态阻力测试,SIC电源设备的短电路和雪崩测试以及更完整的静态和电容性参数测试系统。此外,实验室还引入了一种新的可靠性测试系统,该测试系统着重于评估第三代半导体电源设备的性能。该实验室专门引入了高温操作生命测试方法(HTOL),该方法模拟了在实际工作环境中使设备老化的过程,由于高温而加速了设备的退化,并允许快速获取特征性衰老数据。这些数据不仅包括在内,而且令人信服,还可以在产品保证期和维护计划上提供重要的方向。 HTOL测试还可以预测设备下的平均预期寿命某些操作条件,可以帮助设计师在产品开发和优化期间做出精确的决策。 Tektronix Innovation Lab承诺为客户提供精确的评估和专业指导,快速改善设计并改善产品性能。如果您想评估第三代半导体设备的性能,并确保所选的能源设备满足产品的设计要求,请使用Tektronix Advanced Advanced半导体开放式实验室提供FormFree,并根据专家指导体验精确的评估服务。
由于技术的持续发展,由于其出色的性能,新的能源设备(例如硅(SIC)碳化物(SIC)碳化物(SIC)碳化物(GAN)(GAN))已被广泛用于各种电子设备。但是,这些设备在连续长期使用后会衰老并导致性能较低。如何在短时间内精确地评估这些设备的老化特性已成为行业护理的重点。本文引用:目前,能源设备衰老测试主要意味着多种测试方法。其中,由JEDEC(HTGB,HTRB,H3TRB,功率周期测试等)制定的老化测试标准主要针对传统的硅功率设备。对于诸如SIC之类的较新功率设备,AQG-324标准需要临时动态老化UE,例如动态门偏置和动态逆极化测试。这些传统测试方法中的大多数都使用独特的应力条件来加速能量设备的衰老并了解Agin设备测试特定指标的g。但是,由于压力条件的特异性,这些方法使得在老化测试期间很难评估设备性能。传统的独特张力测试方法无法检测到潜在的缺陷问题,尤其是当它们面对新的能量设备时,这可能会阻碍您真正使用的设备的长期可靠性的确切预测。新的老化测试方法:高温工作状态老化测试,以评估能量设备衰老的较彻底的衰老,高温工作条件的衰老测试逐渐吸引了能量设备测试工程师的注意。 HTOL通过将电源设备放置在实际电源电路中,模拟操作条件下的操作条件。在使用连续硬开关或软开关电路的衰老测试中施加压力时,HTOL可以提供接近实际情况的老化效果,这可以更精确地反射N设备在全面的压力条件下的性能。以硬开关的老化为例,指的是JEP182标准中给出的一些HTOL测试拓扑结构,所测试的设备分别是电路中的硬开关,软开关和InterCoursersistive载荷上升。它可以在拓扑回路的几个结构中找到。这种证明方法可以更全面地模拟设备在现实世界应用中的工作状态,从而使您可以更有效地评估长期可靠性。例如,电路结构类似于双重脉冲形状,在冰点阶段,将功率电阻添加到上管电路中,以消耗电感能量,从而确保在连续开关过程中的当前平衡。由于L电感器的能量在电阻R中消散,因此电阻R会产生大量热量,并且应在高功率中使用大型散热器测试条件,导致更大的电路容量,显着限制了电路运行的总功率,以及在高体积和高电流条件下无法操作的。为了提高衰老效率,通过在衰老过程中改善压力条件并允许能源供应设备解决实际情况,可以改善测试电路。消除了老化电路的电阻载荷,以减少散热量并提高电路的运行效率。电感载荷的使用使食品装置可以在艰苦的切换条件下工作,从而避免能量转化为热量消散。可以按顺序控制四个电源设备中的开关的顺序,Q1/Q4在连续的硬开关条件下运行,而Q2/Q3在自由的当前条件下工作,该条件可以达到连续的硬开关电路,而无需电阻载荷。 QQ Micro 650V GAN HEMT设备用作HTO测试的示例,经常控制LED切换为100 kHz。在连续开关过程中,请使用示波器(TEK),高压电源(高压CC电源EA 1500V)和夹具测试探针(小于100 ns稳定时间)来测量通道中电源设备阻力变化的趋势,并了解通行设备内衬的过程。例如,使用GAN QQ 650V设备在HTOL测试中进行了实际测试用例和结果分析。在测试过程中,使用Tektronix示波器,高压CC电源EE EA 1500V和电动Hunan Lanhai的夹具探测器测量了开关过程中功率设备的电阻趋势。设备开关序列的食物源控制提供了无电压载荷的硬开关电路连续。测试的结果表明,在测试的61 h期间,GAN的电阻动力学和Mosfet de Cree SiC设备基本上保持稳定,而没有显着增加。后520V测试电压的额外增加,在测试245小时后,电阻的动态电阻缓慢增加,但总体情况仍然在合理的范围内。线性调整使您可以在某些条件下预测设备的连续操作寿命。下图使用Tektronix MSO58B系列的示波器显示了动态电阻波形。将电压和电阻电流分开以在特定位置获得动态电阻值。经过长时间的测试,您可以看到动态电阻的相对漂移。在测试期间,Font Decites De Food的连续硬开关会产生开关损失,从而导致自己的热量产生。为避免由影响能量设备特性变化的加热引起的联合温度变化,请通过外部红外温度测试监测设备的温度,并通过热V建立闭路电路以进行温度控制诱使耗散以确保在长期操作期间能量装置连接温度的稳定性。在第一次测试中,选择了QRX Micro TO-247-4包装的功率设备,以将CREE的MOSFET SIC C3M0040120D(1200V/66A)进行比较和测试。测试条件是一致的,与80°C设备的温度,100 kHz开关频率,15A工作电流和400V操作电压。在PRU61 -小时EBA中,我们比较了两种不同类型的设备的动态电阻变化曲线,如下图所示(垂直轴是米利奥姆斯的电阻电阻):蓝色曲线是Cree设备的动态电阻测试的结果,大约1100万。红色曲线表明,GAN设备的动态电阻测试的结果约为54毫米。曲线正面的脉冲峰是由测试过程中调节测试参数引起的。在s期间AME时期,这两个设备的动态电阻基本上保持稳定,并且在测试过程中会发生显着增加。 。在老化过程中,CC电源的输出电压为400 V,CC电流小于100 mA。在测试过程中,单个设备消耗的CC功率少于40 W。与传统的HTOL衰老电流相比,节省了大量能源消耗并降低了测试成本。为了进一步提高衰老率并看到最明显的衰老效应,在第二个测试中,选择了工作电压作为衰老加速度因子,将测试电压从400V增加到520V。由于未更改其他测试条件,因此再次进行了测试。 HTOL的总执行时间增加到245小时,总计29,100个电阻测试结果,每个测试结果为30秒的时间间隔。上图显示,对于大约10天的连续测试,垂直轴数据是动态的结果图中显示了IC电阻测试,水平轴是测试的样品点的序列号,并且正在测试的处置功率IVA的动态电阻变化曲线显示在图中。尽管由于测试环境中的日间变化和夜间温度的影响,测试结果发生了周期性变化,但长期趋势表明,动态电阻正在缓慢增加。与下图同一时期北京的天气数据相比,我们可以看到起伏基本上是相同的,并且环境温度对测试结果具有特定的影响。通过线性调整数据结果,我们可以获得增加动态电阻的斜率约为6.93*E-5。假设能量设备的动态公差增加了30%,则可以达到限制。第二,在80°设备的520V,15a,CA温度的证明下,一个50%的工作周期,设备的连续工作寿命可以达到1724小时。考虑到设备的实际操作电压为400 V,在正常工作条件下的连续时间比此值更长。通过真实的测试数据,我们可以看到,Quanxinwei提供的650V高压GAN设备基本上与SIC设备相同的质量水平就老化的特征而言。当工作电压增加到520V时,可以看出耐受性会缓慢增加,但可以保持较长的工作寿命。一种快速简便的方法,可以通过类似于HTOLCOMPREBER的HTOL老化测试方法来减少衰老过程和新能量设备的性能,并帮助研发工程师和设计快速改善设计并改善生产力的性能。 Tektronix Innovation Lab:帮助您尝试评估能源设备。 Tektronix Innovation Lab v2.0显着提高了可以满足DIV的测试功能ERSE设备测试需要第三代半导体的全面更新和更新和电源设备。该更新涵盖了GAN设备更改测试,动态阻力测试,SIC电源设备的短电路和雪崩测试以及更完整的静态和电容性参数测试系统。此外,实验室还引入了一种新的可靠性测试系统,该测试系统着重于评估第三代半导体电源设备的性能。该实验室专门引入了高温操作生命测试方法(HTOL),该方法模拟了在实际工作环境中使设备老化的过程,由于高温而加速了设备的退化,并允许快速获取特征性衰老数据。这些数据不仅包括在内,而且令人信服,还可以在产品保证期和维护计划上提供重要的方向。 HTOL测试还可以预测设备下的平均预期寿命某些操作条件,可以帮助设计师在产品开发和优化期间做出精确的决策。 Tektronix Innovation Lab承诺为客户提供精确的评估和专业指导,快速改善设计并改善产品性能。如果您想评估第三代半导体设备的性能,并确保所选的能源设备满足产品的设计要求,请使用Tektronix Advanced Advanced半导体开放式实验室提供FormFree,并根据专家指导体验精确的评估服务。 
